作者简介: 王子乐, 女, 2001年生, 同济大学物理科学与工程学院博士研究生 e-mail: 2230979@tongji.edu.cn
物质组分与结构分析是认知和研究物质的重要方式。 利用X射线荧光光谱分析法可以对物质中的元素进行定性分析与定量检测, 该方法是目前最为常规的物质组分和结构无损分析手段之一。 在使用波长色散型X射线荧光光谱仪探测轻元素时, 多层膜分光晶体是核心的光学元件。 使用人工多层膜晶体代替普通晶体作分光晶体, 可有效提升分析仪器对轻元素的检测能力。 针对国产波长色散型X射线荧光光谱仪分析轻元素的实际需求, 设计出了Mo/B4C, Cr/C, Cr/Sc, W/B4C(周期厚度 d=3.63 nm)和W/B4C(周期厚度 d=2.85 nm)多层膜分光晶体, 分别适用于B, C, N, O, F五种轻元素的荧光探测。 利用磁控溅射的方式, 在尺寸为50 mm×30 mm的超光滑Si基底上完成了五种多层膜晶体的制备。 采用高分辨率X射线衍射仪对各个多层膜晶体进行掠入射X射线反射测试, 测试及拟合结果表明: 五种多层膜晶体膜层结构规整、 界面宽度小、 成膜质量高, 膜层均匀性好, 整个镜面上周期厚度的均匀性误差均在1%以内。 采用原子力显微镜表征了各个多层膜晶体的表面形貌, 结果表明: 五种多层膜晶体表面颗粒状结构尺寸较小, 表面形貌平滑, 表面粗糙度小。 最后, 通过模拟计算获得了各个多层膜晶体在掠入射工作角度下的反射率, 分别为: Mo/B4C(30.1%@B-Kα线), Cr/C(29.3%@C-Kα线), Cr/Sc(35.4%@N-Kα线), W/B4C( d=3.63 nm, 8.6%@O-Kα线), W/B4C( d=2.85 nm, 10.7%@F-Kα线)。 基于以上研究, 所制备的五种多层膜分光晶体可以满足波长色散型X射线荧光光谱仪的需求, 能够应用在B, C, N, O, F五种轻元素的探测中。
The composition and structure analysis is an important way to understand and study matters. X-ray fluorescence analysis (XRF) is one of the most universal nondestructive analysis methods for the composition and structure of substances, which can be used for qualitative analysis and quantitative detection of elements in substances. During the detection of light elements by wavelength dispersive X-ray fluorescence spectrometer, multilayer analyzer crystals are key optics. Using artificial multilayer crystals instead of natural crystals as analyzer crystals can effectively improve the ability of spectrometer to detect light elements. This paper, aiming at the actual application demands of domestic wavelength dispersive X-ray fluorescence spectrometer to analyze light elements, Mo/B4C, Cr/C, Cr/Sc, W/B4C (period thickness d=3.63 nm) and W/B4C (period thickness d=2.85 nm) multilayer analyzer crystals are designed, which are suitable for the fluorescence analysis of light elements B, C, N, O, and F, respectively. Five kinds of multilayer crystals have been fabricated using the direct-current (DC) magnetron sputtering technique on super-polished silicon substrates with the size of 50 mm×30 mm by magnetron sputtering. Interfacial microstructures of as-deposited multilayer crystals were characterized by grazing incidence X-ray reflectometry (GIXR) on a high-resolution X-ray diffractometer. The measured results indicate that all five kinds of multilayer crystals have high-quality periodic layer structures and smooth interfaces, and the thickness deviation of period thickness for the five multilayer crystals is less than 1%. Atomic force microscopy (AFM) was used to characterize the surface morphology of each multilayer crystal. The results reveal that all five multilayer crystals have smooth surface morphology and small surface roughness. Finally, the reflectivity of the five crystals at grazing incidence geometry was obtained by simulation: Mo/B4C (30.1% @B-Kα line), Cr/C (29.3% @C-Kα line), Cr/Sc (35.4% @N-Kα line), W/B4C ( d=3.63 nm, 8.6% @O-Kα line), W/B4C ( d=2.85 nm, 10.7% @F-Kα line). Based on these investigations, the five kinds of multilayer analyzer crystals meet the practical application requirements of wavelength dispersive X-ray fluorescence spectrometer. They can be applied to detect light elements B, C, N, O, F.
X射线荧光光谱分析法(XRF)通过测定物质所含元素相应的荧光谱线的波长和强度, 能够实现对元素的定性和定量分析, 该方法凭借分析元素范围广、 分析速度快、 分析精度高、 无损分析等优点, 成为当下物质组分和结构分析的重要手段之一, 广泛应用于工业制造、 食品加工、 地质矿产、 科学研究等诸多领域[1, 2, 3]。 在X射线荧光光谱仪的发展过程中, 如何提高对原子序数小于20的轻元素的检测能力始终是研究者们关注的重点。 轻元素的检测主要通过波长色散型X射线荧光光谱仪(WDXRF)进行, 由于其荧光谱线激发难度大、 产额低, 且极易被样品中其他元素吸收, 使用普通天然晶体作为分光晶体很难对这类荧光信号进行探测。 后来, 随着人工合成多层膜晶体的诞生和迅速发展, 有效解决了轻元素检测难这一问题[4]。 人工合成多层膜用高低原子序数两种材料交替沉积在基底上, 可通过周期厚度d(两种材料厚度之和)的改变来实现实际工作中波长和角度可调节性, 其光谱带宽较普通晶体大1~2个数量级[5], 反射性能优异, 衍射效率高, 且能够抑制高级次衍射线的干扰。 利用人工多层膜晶体代替普通天然晶体有效降低了WDXRF对轻元素的检出限[6], 改善了对轻元素检测的准确度、 灵敏度和稳定性。
目前, 用于轻元素分析的人工多层膜晶体中, 常见的材料组合包括W/Si, Mo/B4C, W/B4C, Ni/B4C, La/B4C, Ni/BN, Ni/C, W/C, Cr/C, Co/C, V/C, TiO2/C等[4, 6, 7, 8, 9, 10, 11, 12]。 德国Incoatec公司研制出了用于分析Be元素和B元素的La/B4C多层膜和用于分析C元素的TiO2/C多层膜, 实际测试结果表明, 用La/B4C多层膜代替普通晶体作分光晶体可以将仪器对B元素的检出限降低30%[7, 8]。 德国Bruker公司制造的WDXRF中同样采用La/B4C多层膜(d=10 nm)和TiO2/C多层膜(d=6 nm)作分光晶体分析Be、 B元素和C元素, 采用Ni/BN多层膜(d=5.5 nm)分析N元素, 对原子序数更大的O~Si元素选择使用W/Si多层膜(d=2.75 nm), 以上多层膜晶体在实际应用中均表现出较高的分析灵敏度[9]。 Platonov等研究了几种用作轻元素荧光反射和单色元件的小周期厚度C基和B4C基多层膜, 结果表明: La/B4C多层膜是分析B元素的最佳选择; 对于C元素的分析, Cr/C多层膜的反射率最高, Co/C多层膜次之, V/C和Ni/C多层膜的反射率相对较低, 但V/C多层膜的光谱分辨率最高; Cr/C多层膜也可用于分析Cl元素和Ar元素; 对于Al~S元素的分析, Mo/B4C多层膜的优势显著, 但其反射率还需进一步提高; W/B4C多层膜在分析O, Na, Mg, Al, Si等元素时均表现出较高的反射率与分辨能力[10]。 André 等也制备了用于分析B元素的周期厚度为4.8 nm的La/B4C多层膜[11]。 IJpes等提出小周期厚度(d=2.5 nm)的W/Si多层膜可对O~Al元素的Kα 谱线进行反射和色散分光, 并在W/Si多层膜中添加0.3 nm厚度的B4C界面阻隔层以提高反射率[12]。 从上述研究中可以看出, 轻元素分析用多层膜分光晶体需要具备高反射率和高光谱分辨能力, 这对膜层材料的选择和膜系结构的设计提出了很高的要求。 而在实际制备过程中, 多层膜分光晶体还需要具备较好的界面质量和膜厚均匀性。 由于多层膜分光晶体中每层膜的厚度都在纳米量级, 界面缺陷会导致其反射率急剧下降从而丧失探测的灵敏度, 因此提高界面质量是多层膜晶体实际制备过程中的一个重要任务。 此外, 多层膜分光晶体的工作角度多为掠入射, 入射光束在其镜面上的投影区域较大, 这便要求多层膜晶体表面的膜层厚度均匀性足够好。
目前, 我国对于WDXRF中轻元素分析用多层膜分光晶体的研究相对较少, 但随着国产WDXRF的进一步发展, 多层膜分光晶体的国产化必不可少。 基于这一需求, 本文开展了针对B, C, N, O, F五种轻元素荧光分析用的多层膜分光晶体的制备和表征研究: 采用直流磁控溅射技术进行制备, 利用掠入射X射线反射和原子力显微镜对各多层膜晶体的周期结构、 界面宽度以及表面粗糙度进行表征, 分析其镜面上不同位置处厚度分布的均匀性, 最后计算了各多层膜晶体在工作波长处的反射率。
在B, C, N, O, F五种轻元素荧光分析谱线(Kα 线)的波长处, 根据多层膜选材原则[13]及材料的物理化学性质, 结合文献和实验室现有条件, 选择了Mo/B4C, Cr/C, Cr/Sc, W/B4C四种材料组合设计多层膜, 利用IMD软件[14]优化膜系结构。
磁控溅射镀膜具有低温、 高速、 稳定性好、 成膜致密、 膜厚控制精度高、 膜层杂质含量少等优点, 由计算机控制基底在不同靶位上的停留时间完成目标膜系的镀制[15, 16], 适合高均匀性软X射线多层膜的制备[17]。 本文中所有的多层膜分光晶体都是在国产超高真空行星转动式直流磁控溅射镀膜设备上镀制完成的, 五种多层膜晶体均沉积在尺寸为50 mm× 30 mm的超光滑Si片上。 在正式制备之前, 对不同材料组合预先进行了多次工艺和速率标定实验, 目的是优化工艺参数、 标定周期厚度和优化厚度均匀性。 实验中真空腔的本底真空度优于8× 10-5 Pa, 溅射气体为纯度99.999%的氩气, 溅射气压为0.133 Pa。 溅射的工作模式为恒功率直流溅射, 金属靶Mo, W, Cr及Sc的溅射功率为200 W, 非金属靶B4C和C的溅射功率分别为400和600 W, 所有溅射靶表面与基底间距均为10.5 cm。 镀膜时, 高速自转的基底以真空腔的中心为圆心公转, 以不同的公转运行速率扫掠过靶材溅射区域来实现不同厚度膜层的镀制。
五种多层膜晶体制备完成后, 使用德国Bruker公司D8 Discover高分辨率X射线衍射仪(Cu-Kα 线)进行掠入射X射线反射(grazing incidence X-ray reflectometry, GIXR)测试, 测试模式为2Theta-Omega联动扫描, 测试角度根据不同多层膜晶体的实际情况确定, 测试步长为0.01° , 积分时间为1 s。 使用衍射仪自带的拟合软件Bede Refs[18]拟合GIXR测试结果, 获得周期厚度、 膜层密度和界面宽度等结构参数。 使用Bruker公司Dimension Icon原子力显微镜(atomic force microscope, AFM)进行表面形貌表征, 扫描尺寸为1 μ m× 1 μ m, 扫描区域像素为256× 256个, 每个样品表面选取三个位置进行测试, 表面粗糙度由三个测试点的平均值计算得出。
2.1.1 用于B元素荧光分析的Mo/B4C多层膜
在周期数为30的Mo/B4C多层膜晶体的50 mm长度方向上选取三个位置进行GIXR测试, 三个测试点分别是样品的中心点和距离中心18 mm的左右两点(本文中对所有多层膜进行GIXR测试的位置选取方式相同), 测试曲线如图1(a)所示。 各条测试曲线峰形尖锐清晰, 重合性较好, 表明在± 18 mm内Mo/B4C多层膜不同位置的膜层结构规整、 界面清晰、 成膜质量高, 周期厚度和成膜质量一致性良好, 同时也说明镀膜设备在长时间溅射过程中工作状态良好、 制备工艺稳定。 对GIXR测试曲线进行拟合, 拟合结果如图1(b)所示, 测试与拟合曲线重合得较好, 说明拟合模型与实际膜层结构相吻合, 拟合得到的Mo/B4C多层膜的结构参数详见表1。 Mo层与B4C层的厚度分别为5.10和4.21 nm, 膜层密度分别为10.20和2.14 g· cm-3。 拟合获得的B4C-on-Mo界面宽度略大于Mo-on-B4C界面, 界面存在不对称性, 平均界面宽度为0.62 nm。 Mo/B4C多层膜在50 mm长度方向的周期厚度均匀性结果如图1(c)所示, ± 18 mm内样品的周期厚度均在9.30~9.31 nm范围内, 误差峰谷值(PV)为10 pm, 最厚点和最薄点的均匀性相差0.11%(PV), 膜厚相对误差的均方根值为0.05%。
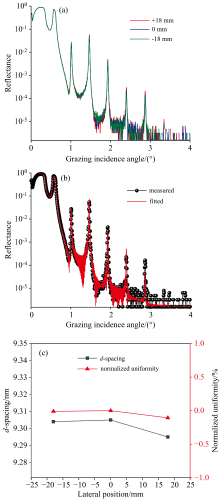 | 图1 Mo/B4C多层膜 (a): GIXR测试曲线; (b): GIXR测试和拟合结果; (c): 周期厚度均匀性Fig.1 Mo/B4C multilayer (a): GIXR measured curves; (b): GIXR measured and fitted results; (c): d-spacing uniformity |
| 表1 Mo/B4C, Cr/C, Cr/Sc, W/B4C(d=3.63 nm)和W/B4C(d=2.85 nm)多层膜的GIXR拟合结果 Table 1 GIXR fitted results of Mo/B4C, Cr/C, Cr/Sc, W/B4C(d=3.63 nm) and W/B4C(d=2.85 nm) multilayers |
2.1.2 用于C元素荧光分析的Cr/C多层膜
图2(a)为周期对数50的Cr/C多层膜晶体的GIXR测试结果, 各条曲线重合较好, 说明在± 18 mm内多层膜各位置处的膜层厚度接近。 对GIXR测试曲线拟合的结果如图2(b)所示, 拟合获得的Cr/C多层膜的结构参数详见表1。 Cr层和C层的厚度分别为2.35和3.03 nm, 膜层密度分别为6.55和2.18 g· cm-3。 拟合得到的Cr-on-C的界面宽度大于C-on-Cr的界面宽度, 平均界面宽度为0.42 nm, 与已报道的文献中的结果基本一致[19]。 Cr/C多层膜在50 mm长度方向的周期厚度均匀性结果如图2(c)所示, ± 18 mm内样品周期厚度的变化范围为5.37~5.38 nm, 误差峰谷值为10 pm, 最厚点和最薄点的均匀性相差0.19%(PV), 膜厚相对误差的均方根值为0.09%。
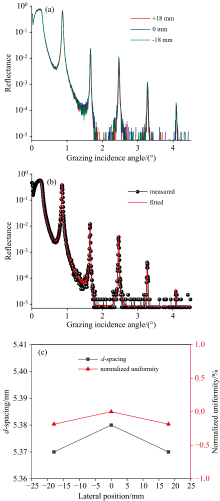 | 图2 Cr/C多层膜 (a): GIXR测试曲线; (b): GIXR测试和拟合结果; (c): 周期厚度均匀性Fig.2 Cr/C multilayer (a): GIXR measured curves; (b): GIXR measured and fitted results; (c): d-spacing uniformity |
2.1.3 用于N元素荧光分析的Cr/Sc多层膜
周期数为60的Cr/Sc多层膜晶体的GIXR测试与拟合结果如图3(a)、 (b)所示, 拟合获得的结构参数详见表1。 Cr层和Sc层的厚度分别为1.55和2.08 nm, 膜层密度分别为6.84和2.84 g· cm-3。 拟合得到的Cr/Sc多层膜膜层内部两种界面存在非对称性, Cr-on-Sc的界面宽度大于Sc-on-Cr的界面宽度, 界面宽度平均值为0.30 nm, 与文献中的结果类似[20]。 Cr/Sc多层膜在50mm长度方向的周期厚度均匀性结果如图3(c)所示, ± 18 mm内多层膜周期厚度均在3.61~3.64 nm范围内, 误差峰谷值为30 pm, 最厚点和最薄点的均匀性相差0.83%(PV), 膜厚相对误差的均方根值为0.35%。 可以发现, 本文制备的Cr/Sc多层膜的厚度均匀性较其他材料组合的多层膜略差, 这主要与溅射靶材粒子的空间分布情况有关, 不同靶材粒子溅射分布的差异使得均匀性分布呈现出不同的趋势。
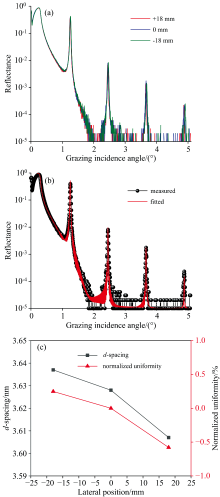 | 图3 Cr/Sc多层膜 (a): GIXR测试曲线; (b): GIXR测试和拟合结果; (c): 周期厚度均匀性Fig.3 Cr/Sc multilayer (a): GIXR measured curves; (b): GIXR measured and fitted results; (c): d-spacing uniformity |
2.1.4 用于O元素和F元素荧光分析的W/B4C多层膜
在Si基底上分别沉积了50和60个膜对数的W/B4C多层膜, 分别用于O元素和F元素的荧光分析, 两种多层膜周期厚度不同, W层的厚度比例均为0.4。 两种W/B4C多层膜的GIXR测试曲线如图4(a)、 (b)所示, 拟合结果如图4(c)、 (d)所示, 拟合获得的各项结构参数详见表1。 用于O元素分析的多层膜中W层和B4C层的厚度分别为1.52和2.11 nm, 膜层密度分别为17.22和2.75 g· cm-3, B4C-on-W界面宽度略大于W-on-B4C界面, 平均界面宽度为0.30 nm, 与文献中的结果相近[21]; 用于F元素分析的多层膜中W层和B4C层的厚度分别为1.34和1.51 nm, 膜层密度分别为18.38和2.14 g· cm-3, B4C-on-W界面宽度略大于W-on-B4C界面, 平均界面宽度为0.32 nm, 与文献中的结果类似[22]。 两种W/B4C多层膜在50 mm长度方向的周期厚度均匀性结果如图4(e)、 (f)所示: 用于O元素分析的多层膜在± 18 mm内周期厚度的变化范围为3.62~3.63 nm, 误差峰谷值小于10 pm, 最厚点和最薄点的均匀性相差0.11%(PV), 相对误差的均方根值为0.05%, 说明该多层膜的周期厚度均匀性非常好; 用于分析F元素的多层膜在± 18 mm内周期厚度的变化范围为2.85~2.86 nm, 误差峰谷值同样小于10 pm, 最厚点和最薄点的均匀性相差0.14%(PV), 相对误差的均方根值为0.06%。 本文为方便对比结构参数不同的样品的成膜情况, 在O元素和F元素的Kα 线波长处, 设计和制备了两种周期厚度不同的W/B4C多层膜。 在实际应用中, 同一结构的W/B4C多层膜只需改变掠入射工作角度便可以同时实现O和F两种元素的荧光探测, 而且还适用于对Na、 Mg、 Al等元素的分析。
为了定量表征多层膜晶体的表面粗糙度, 利用原子力显微镜分别对Mo/B4C, Cr/C, Cr/Sc, W/B4C(d=3.63 nm), W/B4C(d=2.85 nm)多层膜的表面形貌进行了测量, 结果如图5(a)— (e)所示。 五种多层膜晶体的表面颗粒状结构尺寸较小, 表面形貌都比较平滑。 Mo/B4C多层膜与Cr/C多层膜表面的均方根粗糙度分别为0.384和0.373 nm, 与其他三种多层膜相比略大。 Cr/Sc多层膜表面的均方根粗糙度为0.148 nm。 d=3.63 nm和d=2.85 nm的两种W/B4C多层膜表面的均方根粗糙度分别为0.183和0.198 nm。 通过对比可以发现, d=2.85 nm的W/B4C多层膜的表面粗糙度比d=3.63 nm的W/B4C多层膜大, 从这一结果可以推测前者的膜层内部界面粗糙度更大, 这也与GIXR的测试结果相符。
根据B, C, N, O, F五种轻元素Kα 线的波长及GIXR测试得到的各多层膜的周期厚度, 结合布拉格公式mλ =2dsinθ , 确定Mo/B4C, Cr/C, Cr/Sc, W/B4C(d=3.63 nm)和W/B4C(d=2.85 nm)五种多层膜分光晶体的掠入射工作角度分别为22.5° , 25.0° , 25.9° , 19.5° 和19.1° 。 基于表1中GIXR拟合的膜系结构在IMD软件里模拟计算反射率, 图6为五种多层膜在工作波长处的计算反射率曲线, 表2给出了五种多层膜的计算反射率峰值、 光谱带宽Δ λ (FWHM)及光谱分辨率λ /Δ λ 。
 | 图6 Mo/B4C, Cr/C, Cr/Sc, W/B4C(d=3.63 nm)和W/B4C(d=2.85 nm)多层膜的计算反射率Fig.6 Calculated reflectivity of Mo/B4C, Cr/C, Cr/Sc, W/B4C (d=3.63 nm) and W/B4C (d=2.85 nm) multilayers |
| 表2 Mo/B4C, Cr/C, Cr/Sc, W/B4C (d=3.63 nm)和W/B4C (d=2.85 nm)多层膜的模拟计算结果 Table 2 Simulation results of Mo/B4C, Cr/C, Cr/Sc, W/B4C (d=3.63 nm) and W/B4C (d=2.85 nm) multilayers |
利用直流磁控溅射镀膜技术制备了B, C, N, O, F五种轻元素荧光分析用的Mo/B4C, Cr/C, Cr/Sc, W/B4C(d=3.63 nm)及W/B4C(d=2.85 nm)多层膜分光晶体, 并对其进行表征研究。 GIXR测试和拟合结果表明, 五种多层膜晶体周期结构规整、 界面宽度小、 成膜质量高, 在整个镜面上膜厚的均匀性误差均在1%以内, 周期厚度均匀, 成膜质量一致性好。 AFM表面形貌测试给出了五种多层膜晶体的表面粗糙度大小, 五种多层膜晶体的表面形貌都比较平滑、 表面粗糙度小。 在掠入射工作角度下, Mo/B4C, Cr/C, Cr/Sc, W/B4C(d=3.63 nm)及W/B4C(d=2.85 nm)多层膜分光晶体在B, C, N, O, F五种轻元素的荧光分析谱线(Kα 线)波长处的计算反射率分别为30.1%, 29.3%, 35.4%, 8.6%和10.7%, 且均具有较高的光谱分辨能力, 能够满足波长色散型X射线荧光光谱仪的实际需求。 本文制备的五种多层膜分光晶体均可以应用在波长色散型X射线荧光光谱仪中对轻元素进行分析, 为物质组分与结构分析提供了有力的工具。 下一步工作中, 将重点探索反射性能更优的多层膜材料组合, 进一步提升对于多层膜分光晶体的自主研制能力。
| [1] |
|
| [2] |
|
| [3] |
|
| [4] |
|
| [5] |
|
| [6] |
|
| [7] |
|
| [8] |
|
| [9] |
|
| [10] |
|
| [11] |
|
| [12] |
|
| [13] |
|
| [14] |
|
| [15] |
|
| [16] |
|
| [17] |
|
| [18] |
|
| [19] |
|
| [20] |
|
| [21] |
|
| [22] |
|




