作者简介: 谢 卓, 1989年生, 长春理工大学物理学院讲师 e-mail: zxie@cust.edu.cn
激光等离子体极紫外光源具有体积小、 稳定性高和输出波长可调节等优势, 在极紫外光刻领域发挥着重要的作用。 Bi靶激光等离子体极紫外光源在波长9~17 nm范围内具有较宽的光谱, 可应用于制造极紫外光刻机过程中所需的极紫外计量学领域。 利用平像场光谱仪和法拉第杯对Bi靶激光等离子体极紫外光源以及离子碎屑辐射特性进行了实验研究。 在单脉冲激光打靶条件下, 实验中观察到Bi靶激光等离子极紫外光谱在波长12.3 nm处出现了一个明显的凹陷, 其对应着Si L-edge的吸收, 是Bi元素光谱的固有属性。 相应地在波长为11.8和12.5 nm位置处产生了两个宽带的辐射峰。 研究了两波长光谱特性以及辐射强度随激光功率密度的变化。 结果表明, 在改变聚焦光斑大小实现不同激光功率密度(0.7×1010~3.1×1010 W·cm-2)过程中, 当功率密度为2.0×1010 W·cm-2时两波长处的光辐射最强, 其原因归结为Bi靶极紫外光辐射强度受激光能量用于支撑等离子膨胀的损失和极紫外光被等离子体再吸收之间的平衡制约所致。 在改变激光能量实现不同激光功率密度过程中, 由于烧蚀材料和产生两波长所需高阶离子随着功率密度的增加而增加, 增强了两波长处的光辐射。 进一步, 研究了双脉冲激光对Bi靶极紫外光谱辐射特性影响, 实验发现双脉冲打靶下原来在单脉冲打靶时出现在波长13~14 nm范围内的凹陷消失。 最后, 对单脉冲激光作用Bi靶产生极紫外光源碎屑角分布进行了测量。 结果表明, 当探测方向从靶面法线方向移动到沿着靶面方向上的过程中, 探测到Bi离子动能依次减小, 并且离子动能随激光脉冲能量降低而呈线性减小。 此项研究有望为我国在研制极紫外光刻机过程所需的计量学领域提供技术支持和打下夯实的基础。
Laser produce plasma extreme ultraviolet (EUV) source, which has the advantages of small size, high stability and adjustable output wavelength, plays a significant role in applying EUV lithography. Laser produces plasma Bi EUV source has a wide spectrum in the wavelength range of 9~17 nm, which can be used to apply extreme ultraviolet metrology in the development of extreme ultraviolet lithography. Therefore, EUV emission and debris characteristics from laser-produced Bi plasma were carried out. When the 1 064 nm pulse laser irradiated the Bi target, a natural dip displays at 12.3 nm in the EUV spectrum, corresponding to the L-edge absorption in silicon. Meanwhile, two strong peak emissions are located at 11.8 and 12.5 nm, respectively. Firstly, we studied the emission characteristics and intensity of the spectrum near the 11.8 and 12.5 nm dependence on laser power density. When the laser power density is adjusted by changing the focus spot size by fixing the laser energy, the emission intensity of two peaks increases first and then decreases with an increase in the laser power density. The maximum emission intensity of two peaks was formed when the laser power density of 2.0×1010 W·cm-2. This is attributed to the final output EUV emission is determined by the balance of the laser energy loss used to support plasma expansion and reabsorption of the EUV emission by the plasma. When the laser power density is adjusted by changing laser energy by fixing the focus spot size, the emission increases with an increase of laser power density due to the ablation material and high stage ions increases. Secondly, we studied the effect of dual pulse on the emission intensity of the 11.8 and 12.5 nm peaks. The experiment results show that the emission intensity of two peaks increases gradually when the laser energy increases from 20~140 mJ. Moreover, the intensity decreases when the laser energy larger than 140 mJ due to the EUV emission being absorbed by the thick plasma at a larger plasma density. In addition, it is found that the dip generated in the spectrum at a 13~14 nm wavelength with a single pulse laser disappeared when using the dual pulse method. Finally, we measured the angular distributions of ions emission from a 1 064 nm laser-produced plasma. The results indicated that the kinetic energy of Bi ions decreases when the detection direction moves from the normal direction of the target surface to the direction along the target surface due to the plasma preferential expansion perpendicular to the target surface. Moreover, the kinetic energy of Bi ions decreases linearly with the decrease of laser pulse energy. This research is expected to provide technical support and lay a solid foundation for the metrology field needed in the development of EUV lithography.
激光等离子体极紫外(extreme ultraviolet, EUV)光源在高端芯片制造所用的光刻技术中起着重要的作用[1]。 尤其是Sn靶激光等离子体极紫外光源, 其输出波长峰值位于13.5 nm(2%带宽)处[2, 3, 4], 该波长正好处于Mo/Si多层膜反射峰附近, 其反射率可高达70%左右[5], 成功的应用于最先进的极紫外光刻机上面, 可实现7 nm甚至更小光刻节点芯片的制造。
除了将13.5 nm极紫外光源用于光刻机外, 该波长光源以及其他输出波长的一些极紫外光源也有着广泛的应用。 比如, 极紫外计量学是研制极紫外光刻机过程中不可缺少的工具[6], 其可测试光学元件是否满足极紫外光刻机的标准, 并且测试光学器件所需光源应具有较宽波长范围, 因此, 极紫外计量学领域对所需光源具有宽带光谱辐射的要求。 此外, 宽带谱的极紫外光源还可应用于显微镜以及材料表面分析等领域[7, 8]。 然而, Sn靶激光等离子体13.5 nm极紫外光谱为窄带谱, 无法完全满足计量学领域。 研究人员开始寻找新型靶材来产生宽带辐射的极紫外光源。 Tobin等利用激光辅助放电镓铟锡合金等离子体的方法, 在波长10~18 nm范围内产生了宽带的光谱[9]。 同样, Kambali等利用激光烧蚀锡-金合金产生等离子体的方法, 在波长13~18 nm范围内获得了平坦的宽光谱[10]。 最近研究人员发现, 高度电离的Bi(Bismuth)等离子体在8~17 nm范围内产生一个辐射较强且宽带的极紫外光谱[11]。 此外, 金属Bi及其合金可提供一种成本较低、 替代锡-金合金的靶材, 而且一些金属Bi合金接近于室温时是液态, 这一特性使它们更容易用于液滴靶(高工作频率靶的形式)极紫外光源, 应用于研制极紫外光刻机过程中所需的极紫外计量学领域中。 因此, 这些特性促使研究人员对Bi靶激光等离子体的极紫外光辐射进行研究。
到目前为止, 研究人员对高价态Bi离子产生的光谱研究甚少。 早期人们对低价态的Bi中性粒子[12]、 Bi1+和Bi2+ [13]产生的光谱进行了测量和理论分析。 近年来, 人们相继研究了Bi14+产生的光谱[14]。 随后, Wu等研究了波长为1~7 nm范围内的Bi极紫外光谱, 主要是由Bi22+-Bi46+构成的不可分辨跃迁阵列(unresolved transition arrays, UTAs)所贡献[15]。 其中, 高价态Bi离子在跃迁过程Δ =0, n=4-4中产生的不可分辨跃迁阵列辐射位于2.3~4.4 nm范围内[16, 17]。 近期, Liu等研究了波长8~17 nm范围内的Bi靶激光等离子体极紫外光谱, 并对其光谱进行了理论分析[11]。 但是聚焦光斑对Bi极紫外光辐射的影响研究尚少, 并且Bi靶激光等离子体的离子碎屑辐射分布角度特性以及双脉冲对Bi 靶极紫外光辐射影响的研究工作尚未开展。
利用平像场光谱仪和法拉第杯对Bi靶激光等离子体产生的极紫外光源和离子碎屑辐射特性进行研究。 首先, 研究极紫外光谱辐射特性随不同激光功率变化的规律。 其次, 利用双脉冲技术获得了不同预脉冲能量下所产生的极紫外光谱辐射特性的变化规律。 最后, 采用法拉第杯对Bi靶极紫外光源的离子碎屑角分布辐射以及离子碎屑动能进行了测量。
Bi靶激光等离子体极紫外光源以及碎屑辐射特性的实验装置如图1所示。 实验采用重复频率为10 Hz、 脉宽为8 ns、 输出波长为532 nm、 最大能量为250 mJ(Continuum, Surelite Ⅱ )和重复频率为10 Hz、 脉宽为10 ns、 输出波长为1 064 nm、 最大能量为1 J(Continuum, Powerlite Precision Ⅱ )的两台激光器作为产生Bi靶等离子体所用的激光光源。 两光束分别经过M1(532 nm, 45° 高反镜)、 M2(532 nm, 22.5° 高反镜)和M3(1 064 nm, 22.5° 高反和532 nm高透镜)反射镜后合束, 最终通过焦距为400 mm的平凸透镜聚焦于固定在三维平移台的靶材表面。 通过移动透镜与靶材表面的相对距离来获得不同聚焦光斑大小, 进而获得不同的激光功率密度。 聚焦光斑大小的测量是使用单发脉冲激光聚焦在平面靶材上面, 利用金相显微镜获得不同条件下的烧蚀区域直径。 另外, 通过移动三维平移台来更换靶材的位置, 以保证每发脉冲都能辐照在全新的靶材。
采用平像场光栅光谱仪对激光聚焦在Bi靶表面产生的等离子体极紫外光谱辐射进行测量, 为了利于收集较强的极紫外光, 将光谱仪放置与靶面法线成45° 角方向上[18]。 极紫外光经过厚度为200 nm的金属Zr膜、 球面镜、 柱面镜和狭缝, 最后以87° 角入射至中心刻线密度为1 200 l· mm-1的变栅距凹面光栅上, 所获得的衍射光成像到背向照明的X-ray CCD(Andor, iKon-M)上面。 利用Si光谱对光谱仪进行标定, 光谱仪的分辨率约为0.02 nm。
 | 图1 Bi靶激光等离子体极紫外光源以及碎屑辐射特性实验装置图Fig.1 Experimental setup for the EUV emission and debris from laser produced Bi plasma |
在双脉冲实验中, 使用532 nm激光作为预脉冲, 1 064 nm激光作为主脉冲。 采用数字延时发生器(Stanford Research, DG645, 精度小于1 ns)对预、 主脉冲激光和X-ray CCD进行同步控制。 采用由二分之一波片和格兰棱镜组成的衰减器对预脉冲能量进行调节。
采用飞行时间法对Bi靶等离子体光源离子的角分布辐射特性进行测量, 实验中利用法拉第杯电荷收集器对Bi靶等离子体光源产生的离子碎屑进行收集测量。 将法拉第杯放置距离光源10 cm处, 并分别与靶材法向成18° , 36° , 54° 和72° 角。 利用示波器(Tektronix, MDO3054 500 MHz)对所得到的信号进行记录。 整个实验过程中, 均采用单发模式, 真空度约为10-3 Pa。
在激光等离子体极紫外光源研究中, 极紫外光辐射强度依赖于激光功率密度。 通过改变聚焦光斑大小和激光能量来获得不同的激光功率密度。 首先研究聚焦光斑大小对Bi极紫外光谱的影响, 采用单脉冲1 064 nm激光, 固定激光能量为200 mJ, 通过改变聚焦光斑大小来研究不同激光功率密度(0.7× 1010~3.1× 1010 W· cm-2)对Bi靶等离子体极紫外光谱辐射特性的影响, 获得的Bi靶激光等离子体极紫外光谱如图2(a)所示。 与金属Sn[2, 3]和金属Gd[19]光谱相比, 其不是一个较为平滑的光谱, 在波长12.3 nm处产生了一个凹陷, 其对应着Si L-edge的吸收, 是Bi元素的固有属性所导致。 在波长为11.8和12.5 nm附近处产生了宽带且强度较高的光谱辐射, 其由Bi离子4d104fm-15s-4d104fm-15p, 4d104fm-15p-4d104fm-15d, 4d104fm-15d-4d104fm-15f, 4d104fm-15f-4d104fm-15g之间的能级跃迁而产生的UTA所主导[11]。
为了便于观察波长为11.8和12.5 nm附近光谱辐射强度与激光功率密度变化情况, 我们归纳了两波长处光谱峰相对强度与激光功率密度的关系, 结果如图2(b)所示。 随着激光功率密度的逐渐增加, 两条谱线的强度呈现先增加后减弱的趋势, 两者均在激光功率密度为2.0× 1010W· cm-2(对应的聚焦光斑尺寸约为420 μ m)处产生的谱线最强。 通常情况下, 极紫外光谱辐射强度与激光功率密度呈正比关系, 然而图2(b)所示实验结果表明, 在功率密度为2.0× 1010 W· cm-2处产生的极紫外光谱辐射最强。 产生原因如下: 等离子体辐射强度与电子密度平方呈正比, 而电子密度又与激光功率密度呈正比的关系。 因而可知激光功率密度越大, 产生的极紫外光辐射强度越强, 很好的解释了功率密度在0.7× 1010~2.0× 1010W· cm-2区间内, 两波长处的极紫外光谱辐射强度随着激光功率密度的增加而增加的原因。 但是当激光功率密度大于2.0× 1010 W· cm-2时, 两波长处的极紫外光谱辐射强度减弱, 这时候就需要考虑激光等离子体的膨胀动力学过程对极紫外辐射的影响。 极紫外光为了逃脱等离子体, 其必须穿过等离子体的最外层[20]。 对于我们的小聚焦光斑(高激光功率密度)情况来说, 等离子体在靶面法线方向的尺度相对小, 极紫外光容易逃离等离子体。 但是小光斑情况所产生的等离子体沿着靶面方向相比于大光斑情形所产生的膨胀比较明显, 消耗部分激光能量, 减少了产生极紫外所需的能量, 进而减弱了极紫外光输出, 如激光功率密度大于2.0× 1010 W· cm-2所示。 对于大聚焦光斑(低激光功率密度)情况, 增加了激光与等离子体之间的耦合, 有利于激光能量注入至等离子体中转换成产生极紫外所需能量, 此时会增加极紫外光辐射的输出。 但是在该情形下, 产生的等离子体在靶面法线方向尺度较长, 对极紫外光的吸收增加, 导致极紫外光逃脱等离子体的部分减小, 如激光功率密度小于2.0× 1010 W· cm-2所示。 最终的极紫外光辐射强度取决于激光能量用于支撑等离子膨胀的损失和极紫外光被等离子体再吸收之间的平衡。
我们还注意到波长为11.8 nm附近的极紫外谱线峰位置随着激光功率密度的逐渐减弱小幅度地向长波方向移动。 由于每个条件下辐射强度不同, 不利于清晰观察波长为11.8 nm附近EUV光谱峰移动情况。 为此, 我们以11.8 nm附近的光谱峰强度最高值为标准, 将其他实验数据进行归一化处理, 如图3所示。 发现当激光功率密度大于1.7× 1010 W· cm-2时, 波长为11.8 nm附近的EUV谱线峰值位置几乎不发生变化; 而当激光功率密度小于1.7× 1010 W· cm-2时, 谱线峰的位置越向长波的方向移动, 其由于等离子体的电子温度与激光功率密度的0.2次方成比, 即T∝ P0.2 [3]。 再根据CR模型可知激光功率密度低, 对应着电子温度低, 产生的低阶离子数量变多[3], 进而导致谱线峰向长波方向移动。 此外, 波长在13~14 nm区域内, 激光功率密度小于1.7× 1010 W· cm-2时EUV光谱产生了明显的凹陷现象, 这是由于等离子体对于极紫外光来说透明度降低, 等离子体内部产生的EUV光在向外辐射过程中会被等离子体吸收所导致。
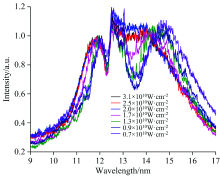 | 图3 不同激光功率密度下, 波长为11.8 nm附近处光谱辐射强度归一化的曲线图Fig.3 Normalized to the maximum intensity in 11.8 nm based on figure 2(a) with different laser power density |
其次, 我们固定最佳聚焦光斑尺寸420 μ m, 通过改变激光能量(130~600 mJ)来获得不同激光功率密度下两波长处的极紫外辐射强度变化规律, 结果如图4所示。 随着激光功率密度的增加, 有利于产生更多的烧蚀材料和产生包含较多辐射两波长处所需高阶离子的等离子体, 进而增强两波长处所产生的光辐射强度。 为了进一步优化极紫外光辐射强度和抑制在13~14 nm区域内产生的自吸收效果而获得应用于极紫外计量学所需的宽带光谱, 我们采用双脉冲方式对Bi靶极紫外光谱进行优化研究。
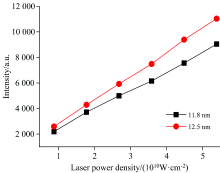 | 图4 不同激光功率密度下波长11.8和12.5 nm处的极紫外辐射强度随激光功率密度变化的曲线Fig.4 The intensity of EUV emission with a wavelength of 11.8 and 12.5 nm dependence on laser power density |
在双脉冲实验中, 先用预脉冲激光(532 nm)烧蚀平面靶产生低密度的预等离子体, 随后主脉冲激光(1 064 nm)加热预等离子体从而产生极紫外光辐射[21]。 我们固定主脉冲能量200 mJ和固定聚焦光斑大小420 μ m, 设置双脉冲的延时为10 ns, 通过改变预脉冲激光的能量(20~160 mJ, 间隔20 mJ)对Bi靶等离子体极紫外光谱辐射特性进行研究。 图5(a)所示为不同预脉冲激光能量下所产生的Bi靶等离子体极紫外光谱曲线。 我们发现与图2(a)的极紫外光谱相比, 双脉冲打靶下其极紫外光谱在波长13~14 nm区域内没有出现单脉冲打靶的凹陷现象, 这说明双脉冲方式可优化等离子体参数, 获得光学薄等离子体进而有效地减弱自吸收效应[22]。 但波长为12.3 nm的凹陷现象仍然存在, 该凹陷是Bi材料光谱的固有属性, 对应着Si L-edge的吸收, 无法通过改变等离子体参数对12.3 nm的凹陷现象进行优化。 同时, 当预脉冲能量小于80 mJ时, 波长为12.5~14.0 nm范围内的EUV光谱曲线轮廓相对平坦。 这样的谱线特点有利于计量学以及其他应用于一些需要平坦光谱的场合[23]。
图5(b)所示为峰值在11.8和12.5 nm附近的极紫外光辐射强度随预脉冲能量变化的关系。 随着预脉冲能量的逐渐增加, 两者的极紫外光辐射强度呈现先增加后减弱的趋势, 在预脉冲能量为140 mJ时极紫外光辐射最强。 其原因如下: 当预脉冲激光能量从20 mJ增加至140 mJ过程中, 预等离子体的密度在逐渐增加, 主脉冲对其加热时可增强EUV光辐射。 但当预脉冲激光能量大于140 mJ时, 主脉冲加热后等离子体的电子密度变高, 等离子体变为光学厚, 不利于两波长处的极紫外光向外辐射, 进而减弱了极紫外光的输出。
最后, 我们对Bi靶极紫外光源产生的离子碎屑(液滴、 中性原子以及快速离子)进行研究。 由于其可飞溅和沉积在光学器件表面, 减少光学器件的使用寿命和降低反射镜的反射率。 因此, 对碎屑辐射特性进行研究, 可为获得低碎屑的极紫外光辐射提供基础。 我们采用单发1 064 nm脉冲激光辐照Bi靶来产生碎屑, 将法拉第杯放置与靶材法线呈18° , 36° , 54° 和72° 方向上来测量不同激光能量下所产生离子碎屑。 图6所示激光能量为600 mJ条件下的离子碎屑典型飞行时间曲线。 从图中可以看出, 每个角度下飞行时间曲线都具有两个信号峰。 在延时为0 μ s附近, 产生了一个快速的并且较弱的信号, 其来源于等离子体光轰击法拉第杯板产生的光电子。 通常情况下, 将该信号峰看作时间的零延时。 随后, 在延时为2 μ s附近产生另外一个强度较高、 上升沿较陡峭和下降较缓慢的信号峰, 其由于大量金属Bi离子进入法拉第杯所导致, 该峰为离子峰。 接下来, 我们根据离子峰的延时来计算得到不同角度下Bi离子所对应的动能。
 | 图6 角度分别为18° , 36° , 54° 和72° 时典型的飞行时间曲线图Fig.6 Typical time of fly profiles of Bi ions with the angles of 18° , 36° , 54° and 72° respects to target normal |
我们对100~600 mJ激光能量下、 不同角度所探测离子信号峰值时间进行归纳总结如图7(a)所示。 随着激光能量的增加, 每个角度所探测离子信号峰值的延时在减少。 根据离子信号峰值时间, 获得极坐标下的离子动能角分布如图7(b)所示。 从图中可以看出, 固定探测角度时, 离子动能随着激光能量的增加而增加。 其由于离子动能E与电子温度Te、 离子平均价态Z满足如下关系[24]
当激光能量逐渐增加时, 电子温度在增加, 离子的平均价态也在增加, 进而导致离子的动能随着激光能量的增加而增加。
当固定激光能量时, 离子动能角分布可用cosn(θ )函数进行拟合, 其中θ 为法拉第杯与靶面法线的夹角。 进而说明离子碎屑在靶面法线方向上具有最大的速度。 其由于激光烧蚀靶材产生等离子体过程中, 等离子体中的热压强会驱使等离子体快速向真空中膨胀。 在形成等离子体的初始阶段, 等离子体的压强梯度与脉冲激光的空间分布相似, 此时, 沿着靶面切线方向的等离子体直径大于靶面法线方向的等离子体直径。 随着延时的逐渐增加, 由于靶面法线方向压强梯度占主导, 导致等离子体会优先选择垂直靶材表面膨胀。 当等离子体沿着靶面切线方向和靶面法线方向的直径接近时, 等离子体停止了优先向前膨胀, 开始以近乎均匀的方式膨胀。 因此, 离子会优先选择靶面法线方向喷溅, 导致离子在该方向上具有较高的动能, 并且离子的量在该方向上增多, 随着角度的增加而减少, 如图6所示。 同时, 靶材法线方向的离子相比于沿着靶面切线方向喷溅的离子来说, 其停留在激光等离子体产生的电场中的时间比较长, 可进一步加速离子和增加靶材法线方向的离子动能。
对Bi靶激光等离子体极紫外光源以及离子碎屑辐射特性进行了研究。 实验结果表明, Bi 靶极紫外光谱在波长12.3 nm处产生了一个凹陷现象, 在波长为11.8和12.5 nm附近处产生了谱带较宽且强度较高的辐射峰。 在改变聚焦光斑尺寸来实现不同激光功率密度过程中, 两个峰均随着激光功率密度的增加呈现先增加后减少的趋势, 最终的极紫外辐射强度取决于激光能量用于支撑等离子膨胀的损失和极紫外光被等离子体再吸收之间的平衡, 在激光功率密度为2.0× 1010 W· cm-2(聚焦光斑尺寸420 μ m)处辐射最强。 在改变激光能量来实现不同激光功率密度过程中, 随着激光功率密度的增加, 有利于产生更多的烧蚀材料和产生包含较多两波长处所需高阶离子的等离子体, 进而增强两波长处产生的光辐射强度。 进一步的实验结果表明, 预脉冲能量从20 mJ增加至160 mJ时, 两波长处的辐射强度先增加后减少, 在能量为140 mJ处极紫外辐射最佳。 并且发现在双脉冲条件下, 在波长13~14 nm区域内没有出现单脉冲打靶的凹陷现象。 此外, 实验结果表明, 改变单脉冲1 064 nm激光能量情况下, 每个探测角度的离子碎屑的能量随着激光能量的增加而变大。 同时, 固定激光能量下, 随着探测角度的增加离子动能角分布可用cosn(θ )函数进行拟合, 这说明等离子体会优先在垂直靶材表面方向上膨胀导致垂直靶材表面方向上的离子动能最大。 由于我国在极紫外光源以及光刻所包含关键技术的研究起步晚于国外发达国家, 导致我国在光刻整体技术方面较为落后, 此项工作有望为我们在研制极紫外光刻机过程中所需的计量学领域提供技术支持和奠定夯实的基础。
| [1] |
|
| [2] |
|
| [3] |
|
| [4] |
|
| [5] |
|
| [6] |
|
| [7] |
|
| [8] |
|
| [9] |
|
| [10] |
|
| [11] |
|
| [12] |
|
| [13] |
|
| [14] |
|
| [15] |
|
| [16] |
|
| [17] |
|
| [18] |
|
| [19] |
|
| [20] |
|
| [21] |
|
| [22] |
|
| [23] |
|
| [24] |
|